

随着芯片特征尺寸的持续减小已逼近物理极限,电子器件的发展已走到瓶颈,传统意义上的摩尔定律被“超越摩尔定律”取代。“超越摩尔定律”不再单纯地追求更小的线宽和更先进的制程,而是试图从更多的途径来维护摩尔定律的发展趋势,当前已演化到集成电路与封装融合发展的新阶段,其中高密度三维封装是融合的核心实现路径。
在高密度三维封装的金属互连中,去除金属氧化物与保持无氧环境是实现金属冶金级键合的前提。金属互连本质是互连金属表面接近原子间作用力平衡距离时,宏观接触表面产生扩散,形成金属键结合。金属表面氧化物无疑会阻碍互连金属的紧密接触。随着微节距结构中的互连点与间隙尺寸已逼近亚微米,物理空间的限制导致涂覆与清洗传统液态或半固态助焊剂难度较高。
针对此问题,近日,半导体所异构集成封装团队与桂林电子科技大学等单位加强多地合作,利用甲酸气氛成功实现了高质量的固液键合,同时通过原位观察发现了甲酸气氛保护下,液态焊料的润湿提升现象。通过进一步的实验设计与材料分析,发现了甲酸带动锡蒸汽迁移的特殊现象(如下图)。在低于液态焊料熔点的温度下,在焊点上成功实现了冶金级的键合,形成了金属间化合物,继而提升了锡基焊料的润湿性。过往许多文献都提出借助甲酸气氛来实现无助焊剂键合,然而大部分文献多在讨论其还原反应机制,较少从冶金结合等观点来探讨此工艺下的材料结合特性。本研究不仅完善了甲酸气氛帮助金属键合的冶金机制,更因为低温下冶金级键合的发现,将为低温键合的应用场景提供新的方案。
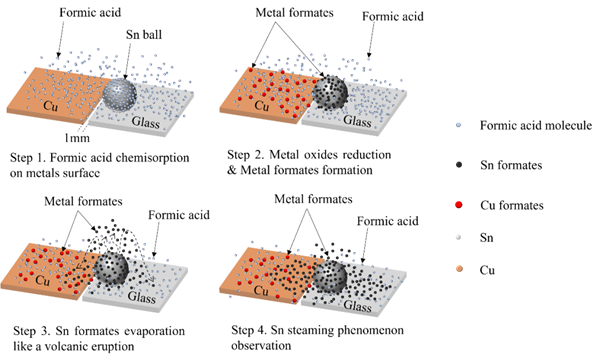
甲酸气氛下锡蒸汽迁移示意图
半导体所异构集成封装团队由国家级人才胡川研究员领衔,长期致力于三维异质异构集成与柔性电子等相关研究。该工作得到了广东重点研发计划、广西自然科学基金、中国博士后基金及广东省科学院打造综合产业技术创新中心行动资金等项目资助,相关成果发表在期刊《Journal of Materials Research and Technology》,团队成员何思亮博士为论文的第一作者。

(供稿:异构集成封装团队)